Automotive industry driving optoelectronics
Car ownership is increasing in emerging markets as cars become more technologically advanced in others. Infrared components and LEDs are playing an increasingly prominent role in this sector. Infrared components, such as light sensors, can be used to detect ambient light to determine when everyone ought to switch on or off headlamps. These types of sensors can also be used to determine whether rain is on the windshield or whether to turn on or off the windscreen wipers. There are also new emerging applications for these kind of infrared components as well. Such as gestured control for the infotainment console in the center of the car. And also there's another application such as night vision to determine whether there's objects or sharp bends in the road. read more...





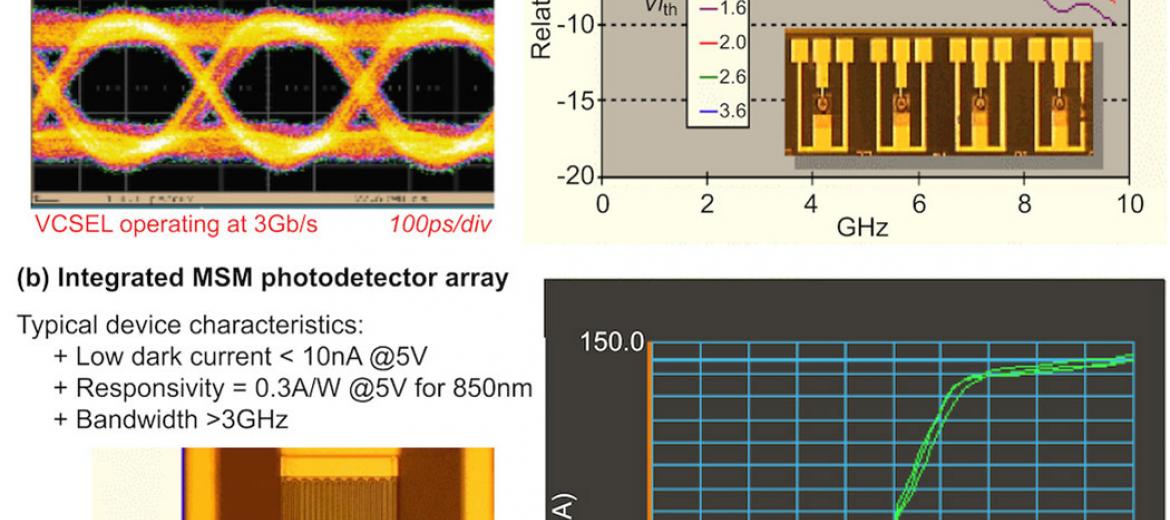








 - Jane Doe
- Jane Doe

